HBM 시장규모가 지속적으로 성장하고 있다. HBM은 고대역폭메모리를 의미하며 일반 메모리반도체의 성능에 비해 월등한 성능을 보이고 있다.
HBM 시장은 2022년 27억 달러에서 2029년 377억 달러로 연평균 46% 성장할 전망이다. 국내 대표 기업으로는 삼성전자와 SK하이닉스가 있다.
HBM 시장의 성장 가능성과 성능을 살펴보고 국내 HBM을 대표하는 두 기업의 현황을 비교해보자.
HBM 뜻
HBM (High Bandwidth Memory), 즉 고대역폭메모리는 다수의 D램을 적층하고 실리콘관통전극으로 수직 연결해 기존 D램 대비 속도와 용량 등을 개선한 메모리반도체를 의미한다.
기존 메모리반도체의 경우 프로세서(CPU, GPU)의 성능이 메모리반도체의 성능보다 빠르게 발전하면서 컴퓨팅 성능이 메모리반도체에 의해 결정되는 Memory Wall이라는 병목현상 발생했다.
프로세서의 성능은 2년마다 3배 발전했으나 D램의 데이터 전송속도(Bandwidth)는 2년간 1.6배 발전해왔기 때문이다.
Memory Wall을 극복하기 위해 메모리의 대역폭과 용량을 확대한 GDDR(Graphics Double Data Rate) D램, HBM 등이 개발되었다.
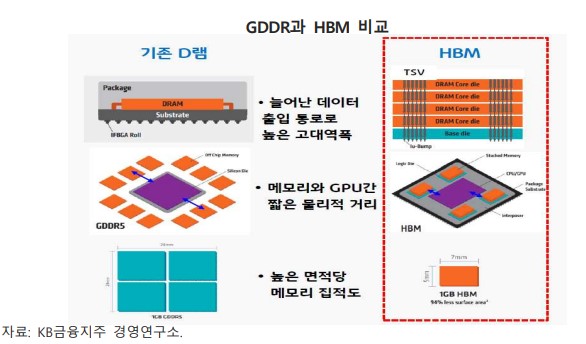
높은 가격에도 불구, 차세대 메모리로 부상
HBM은 GDDR을 대체하기 위해 개발되었으나 높은 가격 등으로 슈퍼컴퓨터 등에서 제한적으로 사용되었다.
HBM의 기술이 발전하고 2022년말부터 생성형 AI 열풍 등으로 고속, 대용량 메모리 수요가 큰 폭으로 증가하면서 HBM이 GDDR을 대체하는 차세대 메모리로 부상했다.
HBM은 데이터 입출력 통로(I/O) 증가로 고대역폭을 제공하며 프로세서와 메모리간 거리가 짧아져 전기적 신호의 이동속도가 빨라진다.
엔비디아는 2020년 A100에 HBM2E, 2022년에는 H100에 HBM3를 탑재했으며 2023년 생성형AI 열풍으로 H100, A100의 수요가 급증했다.
HBM 개발 현황
현재까지 출시된 HBM은 총 4세대이며 약 2년 단위로 기술이 발전했다.
HBM을 선도하는 SK하이닉스는 2014년 HBM(1세대), 2018년 HBM2(2세대), 2020년 HBM2E(3세대), 2022년 HBM3(4세대)를 출시했다.
삼성전자는 2023년 3분기 HBM3(4세대), 2024년 상반기 HMB3E(5세대), 2025년 6세대 제품을 양산할 계획이다.
마이크론은 3세대 HMB2E를 양산중이며 4세대를 건너뛰고 2024년에 5세대 HBM3 공급을 추진하고 있다.
HBM의 세대는 데이터 전송속도, 용량, 적층 단수 등에 따라 분류하며 세대가 진화 할수록 속도는 약 2배, 용량은 50% 증가하는 특징이 있다.

HBM 시장 규모 및 성장 전망
HBM 시장은 2022년 27억 달러에서 2029년 377억 달러로 연평균 46% 성장할 것으로 전망된다.
AI서버 출하량 증가, AI 서버용 프로세서의 HBM 탑재량 증가 등으로 고성장할 것으로 예상된다.
AI서버 출하량은 빅테크의 AI 투자 등으로 2023~2028년에 연평균 20% 성장할 전망이다.
HBM은 AI학습용 프로세서에 주로 탑재되었으나 추론용 프로세서에도 탑재되는 추세, AI 서버용 프로세서가 발전할수록 연산능력 개선을 위해 HBM 탑재량이 증가하고 있다.
엔비디아, AMD, 인텔 등이 자사 칩에 HBM을 탑재하며 인텔은 2023년에 처음으로 HBM을 내장한 서버용 CPU Xeon CPU Max 시리즈를 출시했다.

HBM 판매가격, 완만하게 하락 전망
HBM의 평균 판매 가격은 지속적인 차세대 제품 출시, 수주형 제품 특성 등으로 완만하게 하락할 전망이다.
엔비디아의 고성능 GPU 출시 주기가 2년에서 1년으로 단축되면서 HBM 개발 주기도 HBM3E 이후 1년으로 단축되는 추세이다.
HBM의 주력 제품은 현재 HBM3에서 2025년 HBM3E로 이동하고 2026년에는 HBM4 시장이 개화할 전망이다.
HBM과 일반 D램의 가격차는 현재 5~7배 수준에서 2028년 3배 수준으로 좁혀질 전망이다.
HBM 생산능력은 2023년 93K/월에서 2024년 270~275K/월로 전년 대비 3배, 2025년 에는 410K/월로 전년 대비 1.5배 증가할 것으로 예상된다.
일반 D램은 수급에 의해 가격이 결정되지만 HBM은 고객과 제품 개발, 스펙, 수요 등을 논의하고 주문형으로 제작되어 가격변동성이 상대적으로 낮을 것으로 판단된다.

HBM 시장, SK하이닉스와 삼성전자 양분
HBM 시장점유율은 2023년에 SK하이닉스와 삼성전자가 각 47.5%, 마이크론 5%를 기록했다.
SK하이닉스는 엔비디아의 최대 HBM 공급사로 향후 2~3년간 50% 수준의 시장점유율을 유지할 전망이다.
2022년 HBM3 양산에 최초로 성공해 엔비디아에 단독 공급하면서 HBM3의 시장 점유율은 90% 이상을 기록, HBM3E도 타사보다 먼저 엔비디아에 공급했다.
HBM은 고객사의 Qualification 기간 등이 길어 차세대 제품을 선제적으로 출시하고 고객사의 승인을 받은 기업이 시장을 선점하는 구조로 SK하이닉스가 높은 점유율을 유지할 것으로 예상된다.
삼성전자가 2024년에 엔비디아에 공급하는 HBM 물량은 HBM3/HBM3E 공급지연 등 으로 크지 않을 전망이다.
삼성전자는 선제적으로 HBM2E를 양산하면서 HBM2E 주도권을 확보해 2023년 HBM의 시장점유율은 47.5%를 기록, 주요 구매자는 미국/중국 클라우드 기업이다.
2019년 삼성전자는 불확실한 수요 등으로 HBM 연구개발팀을 해체하면서 HBM3는 SK하이닉스에 점유율을 빼앗겼다.
엔비디아는 삼성전자 HBM3E의 품질 인증을 진행중이며, 2024년말에 출시되는 AMD의 MI325X는 삼성전자의 HBM3E 288GB를 탑재할 예정이다.
마이크론은 SK하이닉스에 이어 엔비디아 H200의 두 번째 HBM3E 공급사로 선정, HBM의 시장점유율은 2023년 5%에서 2026년 10% 수준으로 확대될 전망이다.
2025년 HBM 시장점유율 목표가 D램 수준의 시장점유율(20% 수준)이라고 발표하여 HBM에 대 투자 속도가 가속화될 가능성도 있다.

기술격차 좁혀지고 시장점유율 경쟁 심화 전망
HBM3E 12단은 삼성전자와 SK하이닉스가 각각 2024년 2분기와 3분기부터, 마이크론은 2025년부터 양산할 계획이다.
HBM4는 삼성전자와 SK하이닉스가 2025년에 양산 추진, 마이크론은 2025년 상반기에 HBM4 샘플을 공개할 계획이다.
중국은 2026년까지 HBM2 생산을 추진하나 기술격차 등으로 자국 시장 중심으로 사업을 영위할 전망이다.
HBM은 파운드리와 같은 주문형 제품이며 HBM4부터 고객 맞춤형 제품으로 진화할 것으로 보인다.
일반 D램은 월별, 분기별로 수량과 가격을 협의하나 HBM은 파운드리처럼 제품 출시 전부터 고객과 제품 개발, 수요 등을 논의 후 주문형으로 제작 및 판매가 이루어질 예정이다.
SK하이닉스는 고객맞춤형 HBM을 생산하기 위해 미세공정과 CoWoS 패키징 기술을 보유한 파운드리기업 TSMC와 협력을 강화하고 있다.
삼성전자는 파운드리, HBM, 첨단 패키징을 Turn-key로 제공한다. 2.5D 패키징(아이큐브)을 제공하며, HBM4부터 GPU 위에 HBM을 올리는 3D 패키징 적용을 추진하고 있다.
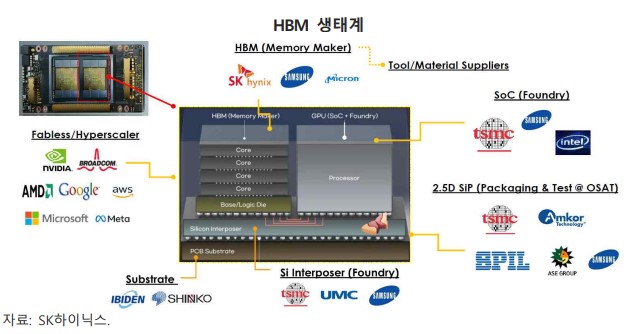
HBM 장비 및 소재
HBM Value Chain에서 TSV 식각, Dicing 장비 등은 일본, 미국기업 중심이나 일부 기업이 TC본더, Reflow 장비 등을 중심으로 국산화를 추진하고 있다.
전공정 장비의 경우 HBM용 TSV 식각장비 등은 미국 Lam Research와 Applied Materials 등이 참여하고 있다.
Lam Research는 삼성전자와 SK하이닉스에 HBM용 식각장비를 독점적으로 공급, Applied Materials 등은 시장진입을 추진하고 있다.
Back Grinder의 경우 전공정에서 가공된 웨이퍼의 후면을 얇게 갈아내는 장비로 일본 Disco가 지배적인 사업자이다. HBM의 적층 단수가 증가하면서 웨이퍼 두께를 얇게 만드는 기술이 중요하다.
Dicing 장비의 경우 웨이퍼를 개별 칩으로 분리해주는 장비로 일본 Disco가 지배적인 사업자이다. 삼성전자와 SK하이닉스는 Disco의 장비를 사용하나 이오테크닉스가 국산화를 추진하고 있다.
본더의 경우 웨이퍼 앞뒷면에 생성된 bump를 서로 접합시켜 단층의 D램을 다층으로 접착시켜주며 한미반도체, 일본 신카와 등이 주요 사업자이다.
한미반도체가 HBM TC 본더 시장점유율 65%를 기록하고 있으며 메모리반도체 기업의 장비 공급사 다변화 정책 등으로 국내기업의 참여도 확대되는 추세이다.
하이브리드 본딩 장비는 Tokyo Electron과 오스트리아 EVG의 장비가 각각 이미지센서와 낸드플래시 생산에 도입되었으며, Applied Materials-네덜란드 Besi, 한미반도체, 한화 정밀기계 등이 HBM용 장비를 개발 추진하고 있다.
